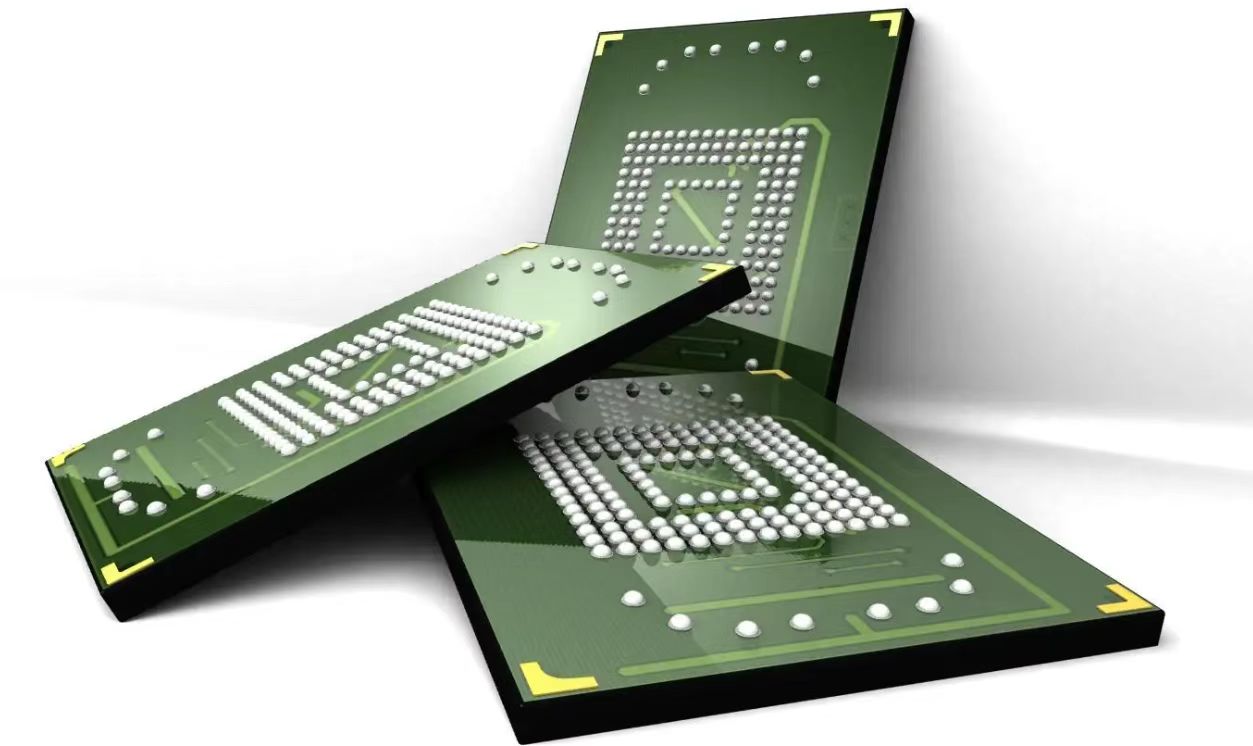
BGA贴装
随着信息处理量的不断加大以及芯片运算速度的提高,IC封装领域愈来愈多的采用高集成度的BGA封装形式,与之相对应的PCB上BGA Pad也大规模的出现,一颗IC的BGA焊点与对应的Pad往往达到几百甚至几千个,其每一点焊接的可靠性变得越来越重要,成为BGA贴装良率的关键。在BGA贴装前对PCB上的Pad进行等离子体表面处理,可使Pad表面达到清洁、粗化和活化的效果,极大的提高了BGA贴装的一次成功率。

软硬结合板
由于软硬结合板是由几种不同的材料层压在一起组成,由于其热膨胀系数的不一致性,孔壁及层与层之间的线路连接容易产生断裂和撕裂现象,提高软硬结合板孔金属化的可靠性和线路层压间的结合力,是软硬结合板质量的关键技术。
传统工艺采用化学药水湿法工艺,其药水的特性非强酸性即强碱性,这都会对聚酰亚胺树脂、丙烯酸树脂等产生不利。利用等离子体对材料表面的清洁、粗化、活化作用的干法处理技术,不但可以得到良好的可靠性和结合力,并能克服传统工艺的缺陷,实现无排放的绿色环保工艺
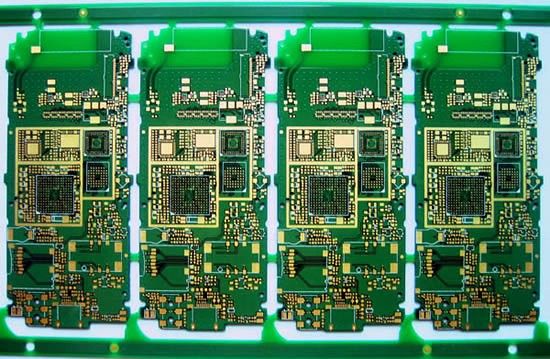
HDI板
HDI是高密度互连的电路板,经低温等离子体处理后能有效去除激光打孔后的碳化物,起到药水无法彻底净化的效果,能对激光打孔后的孔壁及孔底做清洁、粗化与活化处理,大幅度提高激光钻孔后PTH工艺的良率与可靠性,克服镀铜层与孔底铜材的裂纹存在。

FPC板
FPC印刷线路板(软板)其主要材料是由聚酰亚胺树脂组成,由于钻孔时产生的热量,极易使孔内残留大量的树脂胶渣,造成PTH时孔壁镀铜层与内层线路连接不良,甚至产生断裂开路现象,当前业界多采用树脂膨松剂和高锰酸钾药水除孔内胶渣工艺。由于高锰酸钾对聚酰亚胺树脂性能有极大的破坏性。采用低温等离子体处理能有效去除孔壁残胶,达到清洁、活化及均匀蚀刻的效果,有利于内层线路与孔壁镀铜层的连接,增强结合力。在化学沉金,电镀金前经过等离子处理可有效去除焊盘表面脏污,杜绝漏镀;SMT前经过等离子处理可以有效去除焊盘表面脏污,杜绝虚焊。
- 在线咨询
- 微信咨询

微信扫码咨询
- 联系电话
- 电话0755-81452366
- 手机13510501616
- 返回顶部



